Broadcom, yüksek performanslı bilgi işlem (HPC) ve yapay zeka (AI) uygulamaları için tasarlanmış yenilikçi 3.5D XDSiP (eXtreme Dimension System in Package) platformunu tanıttı. Bu teknoloji, büyük ölçekli yapay zeka iş yükleri için özel hızlandırıcılar (XPU) geliştirerek performans ve verimlilikte çığır açıyor.
Broadcom 3.5D XDSiP Platformunun Temel Özellikleri
3.5D XDSiP teknolojisi, 6000 mm²’lik silikon ve 12 yüksek bant genişlikli bellek (HBM) yığınını tek bir pakette entegre ederek düşük güç tüketimi ile yüksek verimli bilgi işlem imkânı sağlıyor. Bu teknoloji, özellikle yapay zeka modellerinin eğitiminde gerekli olan yoğun işlem gücü için tasarlandı. 3.5D XDSiP’nin sunduğu yenilikler:
- Artırılmış Bağlantı Yoğunluğu: F2B (Face-to-Back) teknolojisine göre 7 kat daha fazla sinyal yoğunluğu sağlıyor.
- Düşük Güç Tüketimi: 3D HCB kullanımı ile die-to-die bağlantılarda 10 kat daha düşük güç tüketimi sağlanıyor.
- Düşük Gecikme Süresi: İşlemci, bellek ve I/O bileşenleri arasındaki gecikme süresini minimuma indiriyor.
- Kompakt Tasarım: Daha küçük interposer ve paket boyutları sayesinde maliyet avantajı sunuyor.
Yeni platform, 3D silikon istifleme ve 2.5D paketleme teknolojilerini birleştirerek geleneksel yöntemlerin ötesine geçiyor. F2F (Face-to-Face) teknolojisi, üst ve alt katmanlardaki metal bağlantıları doğrudan birleştirerek elektriksel paraziti azaltmasının yanında mekanik dayanıklılığı da artırıyor.
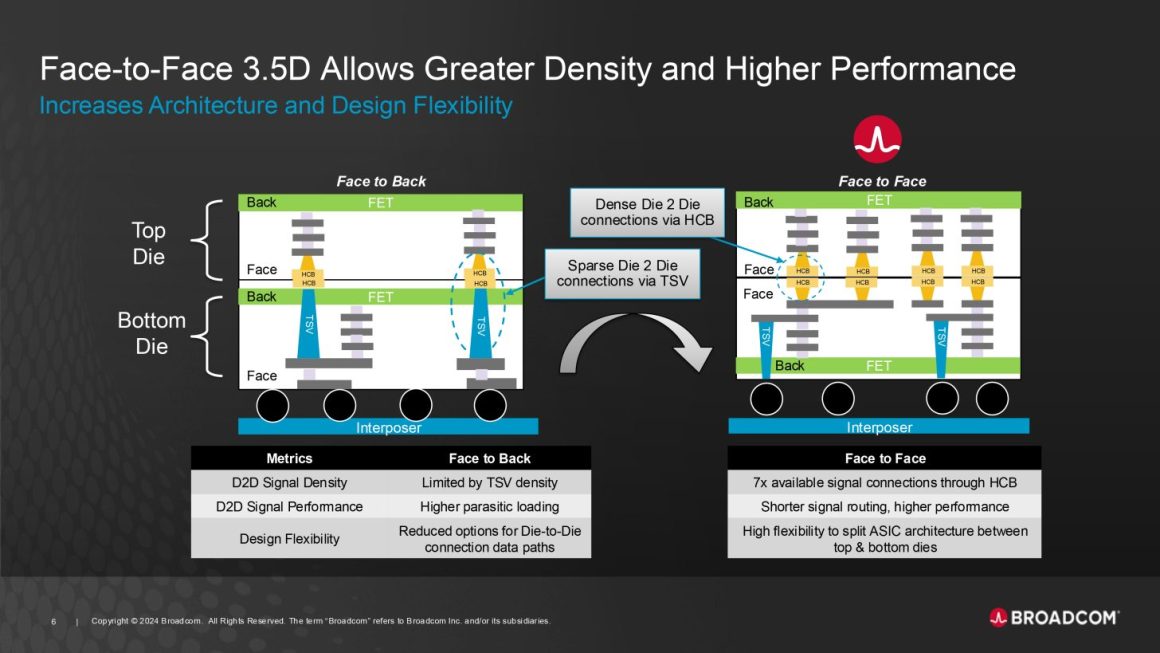
Broadcom’un 3.5D XPU’su ise dört işlemci yongası, bir I/O yongası ve altı HBM modülünü içeriyor. Bu yapı, TSMC’nin en son işlem düğümleri ve 2.5D CoWoS teknolojileri kullanılarak geliştirildi.
Broadcom, 3.5D teknolojisini yapay zeka inovasyonlarına yönelik bir platform hâline getirerek müşterilerinin ihtiyaçlarına cevap vermeyi hedefliyor. Şu anda beş farklı 3.5D ürün geliştirilme aşamasında ve seri üretimin 2026’da başlaması planlanıyor.
Kaynak: wccftech.com